
光創起イノベーション研究拠点では、光の革新的研究を進めるために、文部科学省「地域資源等を活用した産学連携による国際科学イノベーション拠点整備事業」により、次の機器を導入しました。
この5つの機器は、『静岡大学「光創起イノベーション研究拠点」棟機器利用細則』に基づき、ご利用いただけます。
機器利用申請はこちら
![]()
このシステムは、広帯域リアルタイム赤外分光顕微鏡の開発に使用しています。
具体的には、量子カスケードレーザーの適応性検討や生体高分子の分子間相互作用の解明に使用しています。
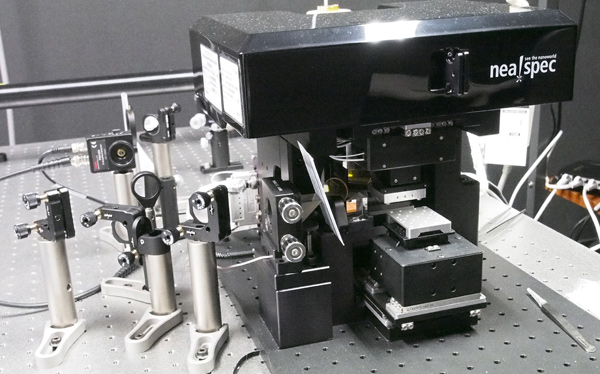
| 〈 製 造 〉 | Neaspec |
|---|---|
| 〈 仕 様 〉 |
|
| 〈 設置場所 〉 | 光創起イノベーション研究拠点棟429室 |
![]()
遠赤外波長域用検出器は、高精度テラヘルツ分光測定装置の開発に使用しています。
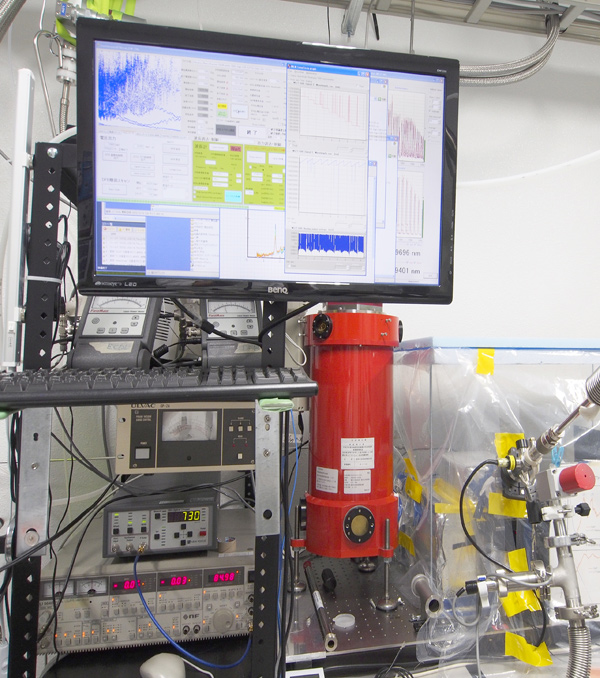
| 〈 製 造 〉 | QMC Instruments Ltd. |
|---|---|
| 〈 型 番 〉 | QNbB/Dry |
| 〈 性 能 〉 | System optical responsivity 168kV/W System RMS output noise at 80 Hz 430nV/√Hz System optical NEP at 80 Hz 2.6pW/√Hz |
| 〈 特長 〉 |
※高精度テラヘルツ分光測定装置として
|
| 〈 設置場所 〉 | 光創起イノベーション研究拠点棟210室 |
![]()
電子線描画装置は、ナノメートルオーダーのパターンを高い解像度と高い位置精度で形成することができます。この装置は、主に「半導体微細構造を応用した機能性光源に関する研究」、「金属微細構造を応用した光機能素子に関する研究」、「半導体微細構造を応用した電子機能素子に関する研究」で使用しています。

| 〈 製 造 〉 | 日本電子(株) |
|---|---|
| 〈 型 番 〉 | JBX-6300SP |
| 〈 仕 様 〉 | 加速電圧 100kV/50kV/25kV 電子銃 ZrO/W 電子線走査の最大クロック周波数 50MHz 基板サイズ 200mm最大 |
| 〈 特 長 〉 |
|
| 〈 設置場所 〉 | 光創起イノベーション研究拠点棟101室 |

このシステムは、試作する撮像素子をウェハ段階でプロービングし、遮光/光照射状態で機能テストを行うことができます。
主に、「高分解能近赤外分光イメージングシステム開発」、「超高感度・高機能集積バイオイメージング技術の開発」、「超高精細画像・3次元画像センシング・音像制御等に基づく遠隔再現技術の開発」に使用しています。
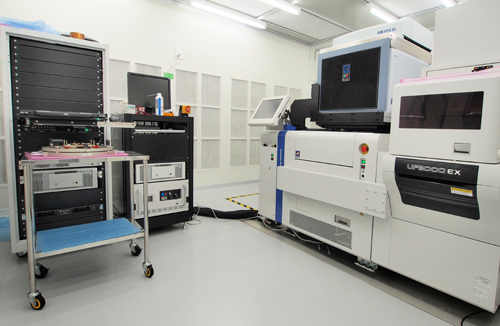
| 〈 製 造 〉 | プローバー (株)東京精密 テスター テラダイン(株) 光源 応用電機(株) |
||||||
|---|---|---|---|---|---|---|---|
| 〈 型 番 〉 | プローバー UF3000EX テスター IP750EX 光源 AW1053L |
||||||
| 〈 特 長 〉 |
|
||||||
| 〈 設置場所 〉 | 光創起イノベーション研究拠点棟224室(2階クリーンルーム内) |
![]()
レーザー直接描画装置は、中性子、X線、紫外、テラヘルツ検出素子、イメージングデバイス、無給電センサ用発電デバイス等の試作に使用しています。
主に、「波面制御光源による産業・医療分野のパラダイムシフトの実現」、「赤外分光計測技術の革新と分子間相互作用の解明」、「革新的時空間像構築(イメージング)技術の実用化」、「光時空間遠隔制御(光リモート)技術の革新」の諸課題に取り組みます。
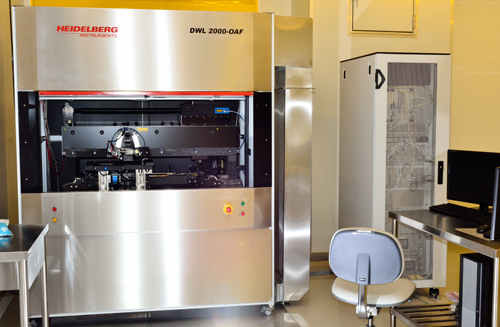
| 〈 製 造 〉 | 独 ハイデルベルグ・インストルメンツ |
|---|---|
| 〈 型 番 〉 | DWL2000-OAF |
| 〈 仕 様 〉 | 最大描画エリア 200×200㎟ アドレス・グリッド 20nm 最小描画サイズ 0.7μm 描画スピード 110㎟/分 エッジラフネス(3σ) 70nm CD均一性(3σ) 80nm アラインメント精度(3σ) 80nm |
| 〈 特 長 〉 |
|
| 〈 設置場所 〉 | 光創起イノベーション研究拠点棟124室 |
- 2024/01/25
- 2023/11/17 HAMAMATSU異分野交流会を開催しました
光創起イノベーション研究拠点棟 〈光創起研究棟〉
〒432-8011 静岡県浜松市中央区城北3丁目5-1 国立大学法人静岡大学浜松キャンパス内
TEL:053-478-3271 / FAX:053-478-3256










